![]()

彦根藩二代当主である井伊直孝公をお寺の門前で手招き雷雨から救ったと伝えら
れる"招き猫"と、井伊軍団のシンボルとも言える赤備え。(戦国時代の軍団編成
の一種で、あらゆる武具を朱塗りにした部隊編のこと)の兜(かぶと)を合体さ
せて生まれたキャラクタ。
宇
恋歌のひとつふたつを詠うべき 梅咲き薫る季節まてり
筑波峰の 峰より落つる男女川恋ぞつもりて淵となりにる
陽成院
※ 陽成院(ようぜいいん 868~949年)は清和天皇の第一皇子、十歳のときに
第五十七代天皇として即位さ、病気などで、わずか十五才(或いは十七才)で廃位
され、皇位を孝徳天皇に禅譲。百人一首・第20番を詠んだ元良親王(もとよしし
んのう)は陽成天皇の第一皇子、上皇の陽成院は、孝徳天皇の内親王に恋をしこ
の和歌は恋心を詠ったものと伝承され、筑波山ではなく、そこから流れ出るみな
の川を取り上げ、その情景から小さな恋心が、やがては大きく育っていく様をう
まく重ねた歌とされる。
※ 短歌、俳句を捻る余裕がなく、眼精疲労、胃腸不良を配慮し休養するように
している。恋歌をどうこうする様な年齢ではないかと反発してみる。
【能登半島地震:防災・医療用水製造システム】
特に公共施設向け(例:ホスピタル)で総合病院で手洗い洗浄作業などが出来な
かった旨の放送がされていた。下記のような空気の除塵・殺菌(除菌)処理し水
蒸気を冷却し常時長三商品が販売されている(日本製)。技術的アプローチの選
択は数多くあるが、セフティ。コスパ、コンパクト、ロバスト、コンビニエンス、
等生成速度の改良の課題はのこるるため。後日、調査結果を報告する。
※事例:雑誌名:「Science」(オンライン版:5月12日)
論文タイトル:Ultrafast water permeation through nanochannels with a densely fluorous
interior surface.
DOI番号:10.1126/science.abd0966
![]()


第5産業勃興?!
イーロン・マスクの脳改造企業「Neuralink」が初のヒト臨床試験に成功
考えるだけでPCを操作
製品名は「テレパシー」!?
[関連特許]
5.特開2023-179710 MIS型半導体装置の製造方法
【0030】 なお、ゲート絶縁体層23は、終端処理されたダイヤモンド半導体層
22の表面に直接接して、水、炭化水素やレジスト残渣などの層を挟まないこと
が好ましい。このような層を挟むと、界面準位が発生しやすいためである。
【0031】 ゲート絶縁体層23としてAl2O3などの非晶質膜を用いた従来構造
では、ゲート絶縁体層23中およびゲート絶縁体層23とダイヤモンド半導体層
22との界面にトラップ(電荷トラップ)が多く含まれる傾向がある。このため
、キャリア伝導は散乱を受け、キャリア移動度は低いものとなる。 一方、ゲート
絶縁体層(ゲート絶縁膜)として窒化ホウ素、好ましくは単結晶の窒化ホウ素、
より好ましくはh-BN、さらに一層好ましくは単結晶のh-BNを用いた本発
明の構造では、ゲート絶縁体層23中の電荷トラップは少ない傾向がある。この
ため、キャリア伝導は散乱が少なく、高いキャリア移動度が得られる。
-----------------------------------------------------------------------
【参考】
MIS構造とは金属-絶縁体-半導体(metal-insulator-semiconductor)からな
る3層構造である。
➲ MIS構造 (MIS structure)
➲【半導体工学】金属-絶縁体-半導体構造とは (MIS構造,MOS構造)
-----------------------------------------------------------------------
【0032】 ダイヤモンド基板21は、その上に形成するダイヤモンド半導体層22
が欠陥の少ない高品質な結晶になるように、結晶欠陥が少なく、清浄度が高く、
平坦、平滑な表面をもつことが好ましい。また、表面ラフネス散乱の影響を低減
するため、半導体層の表面も平坦、平滑であることが好ましい。
【0033】 ゲート電極24は、閾値電圧VTHが負電圧になるような仕事関数をも
つ導電材料からなる。具体的には、金属、グラファイト(C)またはドーパント
が添加されたポリシリコンなどの導電膜を挙げることができる。金属としては、
銅(Cu)、タングステン(W)、チタン(Ti)、アルミニウム(Al)、ク
ロム(Cr)およびタンタル(Ta)などを挙げることができる。また、AlCu、
CuNiFeおよびNiCrなどの合金、WSi、TiSiなどのシリサイドお
よびポリサイド、WN、TiN、CrNおよ びTaNなどの金属化合物も用い
ることができる。ゲート電極24は、このような材料の中から導電率、仕事関数、
加工性などを適宜勘案して適当な材料を選択すればよい。 なお、閾値電圧VTHは、
ゲート電極24の材料、ゲート絶縁体層23の材料とその膜厚、半導体チャネル
層の材料、不純物およびその密度などに左右される。 また、集積回路として本
発明のMIS半導体装置を用いる場合は、インテグレーションとしての各種熱処
理が加わることから、それらの熱処理も勘案した材料の拡散を考慮の上、材料を
選択する。
【0034】ソース電極とその配線28、ドレイン電極とその配線29およびゲート
電極配線27は、金属、グラファイト、あるいはドーパントが添加されたポリシ
リコンなどの導電膜からなる。金属としては、金(Au)、銀(Ag)、Cu、
白金(Pt)、パラジウム(Pd)、W、Ti、Al、CrおよびTaなどを挙
げることができる。また、AlCu、CuNiFeおよびNiCrなどの合金、
WやTiなどを用いたポリサイド、WN、TiN、CrNおよびTaNなどの金
属化合物も用いることができる。これらの導電膜は、ダイヤモンド半導体層22
と接する部分でオーミックコンタクトが取れることが好ましい。例えば、導電膜
として、金(Au)、パラジウム(Pd)などの高い仕事関数を有する金属を用
いることが好ましい。これらの高仕事関数の金属は直接接触でオーミックコンタ
クトがとれるという特徴がある。また、チタン(Ti)を用いることもできる。こ
こで、Tiは、アニールしてダイヤモンドと反応させてTiCを形成しておくこ
とが好ましい。一方で、Tiは酸化されやすいので、ダイヤモンド半導体層22
と電気的接触をとる場合は、ダイヤモンド半導体層22側からTi、その上にPt
やAuやWといった材料が積層された導電膜構造とすることが好ましい。
【0035】 また、ソース電極28およびドレイン電極29とのオーミックコンタ
クトを確実にとり、ダイヤモンド半導体層22のチャネル部以外の抵抗を下げる
ために、低抵抗化層26をダイヤモンド半導体層22とソース電極28やドレイ
ン電極29との界面に形成しておくことが好ましい。例えば、ソース電極28お
よびドレイン電極29がTiからなるときの低抵抗化層としてはアニール形成に
よるTiCを挙げることができる。
【0036】 あるいは 111のものを好んで用いることができる。 ここで、ダイヤモ
ンド基板21の表面は、平坦(平面)で原子レベルの平滑な面であることが好ま
しい。電界効果トランジスタの電気特性としては、ダイヤモンド半導体層22と
ゲート絶縁体層23との界面の平坦性、平滑性が重要であるが、その界面の平坦
性、平滑性を十分高いものにするためには、ダイヤモンド基板21表面の平坦度、
平滑度および清浄度を十分に高めておく必要がある。
【0038】 その後、図3(b)に示すように、ダイヤモンド基板21上に 終端が
水素になっているダイヤモンド半導体層をエピタキシャル成長させて、水素終端
されたダイヤモンド半導体層22を形成する(図5のS1)。水素終端されたダ
イヤモンド半導体層22は、例えば、CH4ガスとH2ガスを用いたマイクロ波プ
ラズマCVD(Chemical Vapor Deposition)により成
膜することができる。ダイヤモンド半 導体層22の厚さは10nm以上が好ま
しい。厚さが10nm以上である と、特にIb基板の場合に、基板からの不純
物の混入を抑制することがで きる。
【0039】 ダイヤモンド半導体層22には、ドーパントが添加されていて もよい。
ホール系のドーパントとしてはホウ素(B)を、また電子系の ドーパントとし
てはリン(P)を挙げることができる。ドーパントの添加 量としては、1016
/cm3以上1019/cm3以下が好ましい。1016/ cm3未満ではドーパント
添加の効果が小さく、1019/cm3を超えると キャリア散乱要因となって移動
度などの性能が低下する。
【0040】 次に、ダイヤモンド半導体層22の表面(少なくとも第1主表面)が
水素終端された直後から、試料の置かれている環境が真空、水素ガ ス、不活性ガ
スおよび不活性ガスが添加された水素ガスからなる群より選 ばれる何れかの
1つになるように、排気または/および不活性ガス置換を 行う(図5のS2)。
不活性ガスとしては、Arガス、Krガス、Xeガ ス等の貴ガスおよびN2ガス
を挙げることができる。ここで、この真空、 水素ガス、不活性ガスおよび不活性
ガスが添加された水素ガスからなる群 より選ばれる何れかの1つの環境は、少
なくとも後述の絶縁膜23aを形 成する直前まで維持されるようにする。この
ようにすることにより、ダイ ヤモンド半導体層22と絶縁膜23aとの界面の
荷電不純物は少なくなり、 高いホール移動度が得られるようになる。
【0041】 なお、次工程の絶縁膜23a形成がCVDなど、一旦真空環境 下にお
いてなされる処理の場合は、試料環境を真空に置いておくことが効 率的で好ま
しく、絶縁膜23a形成が貼り合わせなどの場合は、作業効率の観点から不活性
ガス環境に置くことが好ましい。なお、不活性ガスとしては、不活性度、純度の
確保およびコストを総合的に勘案して、Arガス が最も好ましい。絶縁膜25は、
電気的に絶縁するとともに水分や不純物の拡散を防止して、MIS半導体装置10
1の安定動作に一役を担うものである。その材料としては、酸化シリコン(Si
O2)膜、窒化シリコン(SiN)膜、酸化窒化シリコン(SiNO)膜、炭化
シリコン(SiC)膜、炭化窒化シリコン(SiCN)膜、炭化窒化酸化シリコ
ン(SiCNO)膜、アルミナ(Al2O3)膜、窒化ホウ素(BN)膜およびポ
リイミドなどの有機膜などを挙げることができる。
図5.MIS型半導体装置の製造工程を説明するフローチャート図
【0037】
<製造方法>
次に、このMIS型半導体装置101の製造方法を、断面構造を示した図3、4お
よびフローチャートで示した図5を用いて説明する。 まず、図3(a)に示すよ
うに、ダイヤモンド基板21を準備する。ダイヤ結晶面が100図5 MIS型半導
体装置の製造工程を説明するフローチャート
図3.MIS型半導体装置の製造工程を断面図にて示した製造工程図
ここで、ダイヤモンド基板21の表面は、平坦(平面)で原子レベルの平滑な面
であることが好ましい。電界効果トランジスタの電気特性としては、ダイヤモン
ド半導体層22とゲート絶縁体層23との界面の平坦性、平滑性が重要であるが、
その界面の平坦性、平滑性を十分高いものにするためには、ダイヤモンド基板
21表面の平坦度、平滑度および清浄度を十分に高めておく必要がある。 その
後、図3(b)に示すように、ダイヤモンド基板21上に終端が水素になってい
るダイヤモンド半導体層をエピタキシャル成長させて、水素終端されたダイヤモ
ンド半導体層22を形成する(図5のS1)。 水素終端されたダイヤモンド半
導体層22は、例えば、CH4ガスとH2ガスを用いたマイクロ波プラズマCVD
(Chemical Vapor Deposition)により成膜することが
できる。 ダイヤモンド半導体層22の厚さは10nm以上が好ましい。厚さが1
0nm以上であると、特にIb基板の場合に、基板からの不純物の混入を抑制す
ることができる。
【0039】 ダイヤモンド半導体層22には、ドーパントが添加されていてもよい。
ホール系のドーパントとしてはホウ素(B)を、また電子系のドーパントとして
はリン(P)を挙げることができる。ドーパントの添加量としては、1016/
cm3以上1019/cm3以下が好ましい。1016/cm3未満ではドーパント添
加の効果が小さく、1019/cm3を超えるとキャリア散乱要因となって移動度
などの性能が低下する。
【0040】 次に、ダイヤモンド半導体層22の表面(少なくとも第1主表面)が水
素終端された直後から、試料の置かれている環境が真空、水素ガス、不活性ガス
および不活性ガスが添加された水素ガスからなる群より選ばれる何れかの1つに
なるように、排気または/および不活性ガス置換を行う(図5のS2)。不活性
ガスとしては、Arガス、Krガス、Xeガス等の貴ガスおよびN2ガスを挙げ
ることができる。ここで、この真空、水素ガス、不活性ガスおよび不活性ガスが
添加された水素ガスからなる群より選ばれる何れかの1つの環境は、少なくとも
後述の絶縁膜23aを形成する直前まで維持されるようにする。このようにする
ことにより、ダイヤモンド半導体層22と絶縁膜23aとの界面の荷電不純物は
少なくなり、高いホール移動度が得られるようになる。
【0041】 なお、次工程の絶縁膜23a形成がCVDなど、一旦真空環境下にお
いてなされる処理の場合は、試料環境を真空に置いておくことが効率的で好まし
く、絶縁膜23a形成が貼り合わせなどの場合は、作業効率の観点から不活性ガ
ス環境に置くことが好ましい。なお、不活性ガスとしては、不活性度、純度の確
保およびコストを総合的に勘案して、Arガスが最も好ましい。
【0042】 真空に置かれる場合は、その効果と設備負担を鑑みて真空度は1×1
0-5Pa程度が好ましい。 不活性ガスを使用する場合は、大気圧が取り扱いの
容易さから好ましい。ここで、大気圧とは、低気圧、高気圧、高所を含む大気環
境下での圧力、およびグローブボックス等で外気が混入しないように与圧にした
状態を含む圧力を指す。また、環境中の酸素ガス(O2ガス)の濃度は0.5pp
m以下、露点は-80℃以下が好ましい。 水素終端されたダイヤモンドの表面
は化学的に安定であり、このレベルの環境で荷電不純物が少なく、荷電不純物散
乱の少ない高いホール移動度を得るに好適な半導体層としての表面状態を得るこ
とができる。
【0043】 その後、図3(c)に示すように、水素などで終端処理されたダイヤ
モンド半導体層22上に、絶縁膜23aを形成する(図5のS3)。ここで、絶
縁膜23aとしては、窒化ホウ素が好ましく、窒化ホウ素の単結晶が特に好まし
く、h-BNがより一層好ましく、h-BNの単結晶がさらに一層好ましい。以
下、効果の高い、絶縁膜が窒化ホウ素の場合を例にして説明する。 絶縁膜23a
は、劈開して得られた窒化ホウ素薄膜の貼り合わせ法、熱CVDやプラズマCV
Dなどの化学的気相成長法、スパッタリングなどの物理的気相成長法、および物
理 化学的気相成長法などにより形成することができる。具体例としては、トリ
エチルボラン(TEB)とアンモニア(NH3)を原料ガスとし、キャリアガス
に水素(H2)を用いた有機金属気相成長法(MOCVD:Metal-Org
anic Chemical Vapor Deposition)、RFプラズ
マにより作 製した活性窒素と電子銃により加熱供給されたホウ素を用いた分子
線エピタキシ ー法(MBE:Molecular Beam Epitaxy)
などを挙げることができる。 なお、絶縁膜23aを劈開して得られた窒化ホウ
素薄膜の貼り合わせで形成する場合は、その貼り合わせ環境が、真空、水素ガス、
不活性ガスお よび不活性ガスが添加された水素ガスからなる群より選ばれる何れ
かの1つであ ることが好ましい。すなわち、絶縁膜23aの形成工程の環境が、
真空、水素ガ ス、不活性ガスおよび不活性ガスが添加された水素ガスからなる
群より選ばれる 何れかの1つであることが好ましい。
【0044】 なお、ダイヤモンド半導体層22と絶縁膜23aとの界面の吸着物の
除去と絶縁膜23a表面の清浄化のため、絶縁膜23aを形成した後に、不活性
ガスと水素(H2)ガスとの混合ガスを用いたアニールを行うことが好ましい。
ここで、不活性ガスとしては、例えば、アルゴン(Ar)を挙げることができる。
【0045】 その後、図3(d)に示すようにゲート電極24を形成する(図5の
S4)。 このゲート電極24の形成方法としては、ゲート電極24を構成する
導電材料をスパッタリング法、蒸着法、CVD法および貼り合わせ法などで絶縁
膜23a上に被着させた後、リソグラフィによってレジストパターンを形成し、
引き続きエッチングを行って形成する方法が挙げられる。このエッチングとして
は、微細加工性の観点からドライエッチングが好んで用いることができるが、ウ
ェットエッチングを用いることもできる。ウェットエッチングの場合は、作製さ
れるMIS型半導体装置101へのダメージを抑制しやすいという特徴がある。
また、リフトオフ用のレジストパターンを絶縁膜23a上に形成した後、ゲート
電極24を構成する導電材料をスパッタリング法、蒸着法、CVD法などで堆積
させ、リフトオフする方法も挙げることができる。
【0046】 ここで、スパッタリング法としては、DCスパッタリング法、RFス
パッタリング法などを挙げることができるが、スループットの観点からはRFス
パッタリング法がより好ましい。蒸着法としては、加熱蒸着法や電子線蒸着法な
どを挙げることができる。ゲート電極24の材料としてポリシリコンを用いると
きは、ポリシリコンの成膜法としてCVD法を好んで用いることができる。この
際、リン(P)などのドーパントを添加して、低抵抗化しておくことが好ましい。
【0047】 その後、絶縁膜25aをスパッタリング法、ALD法、CVD法、貼
り合わせ法、またはSOG(Spin on Glass)などの塗布法によって
形成する(図4(a))。 ここで、成膜した絶縁膜25aには、電気特性の安
定化に妨げとなる空孔や所望ではない水が含まれることが多いので、アニールを
施しておくことが好ましい。
【0048】 引き続き、リソグラフィとエッチングによって絶縁膜25aおよびゲ
ート絶縁膜23aに所望の開口を形成して、それぞれ絶縁膜25およびゲート絶
縁体層(ゲート絶縁膜)23とする(図4(b))。
【0049】 その後、電極と半導体層とのオーミック接触をとり、かつ低抵抗とす
る低抵抗化層26を開口部のダイヤモンド半導体層22露出面に形成する(図4
(c))。低抵抗化層26は、TiやMoなどダイヤモンドと炭化物を形成する
金属を堆積させたのちに、アニールによって金属炭化物を形成することで得るこ
とができる。また、水素終端半導体層に対しては、堆積させたAu,Pd,Pt
などの高仕事関数金属を低抵抗化層とすることができる。
【0050】 しかる後、導電膜の堆積、リソグラフィおよびエッチングを行ってゲ
ート電極配線27、ソース電極およびその配線28、ドレイン電極およびその配
線29を形成する(図4(d))。 なお、前述の低抵抗化層26は、これらの
電極または/および配線を形成した後にアニールを施すなどして形成してもよい。
以上の工程により、ダイヤモンド半導体層22とh-BNからなるゲート絶縁体
層23を有するMIS型半導体装置101が作製される。
【0051】 本発明のMIS型半導体装置101は、キャリア移動度(ホール移動
度)が高く、ノーマリーオフ動作によりオフ時(待機時)の消費電力が少ないと
ともに、オン時も相互コンダクタンスgmが高く、オン抵抗も少ないので消費電
力が少ない省エネルギーに好適な半導体装置である。待機時は殆ど通電しないた
め、セキュリティ上も好ましい。 したがって、本発明により、移動度とキャリ
ア密度の両特性を高いレベルで兼ね備えた高性能MIS型半導体装置が提供され
る。
【0052】 上記では、単体のMIS型半導体装置101の作製方法を説明したが、
MIS型半導体装置101が複数載置されて集積化されたMIS型半導体装置も
同様にして作製することができる。この場合、各MIS型半導体装置101間に
絶縁層を設け、必要に応じて素子分離を行う。
【0053】 (実施の形態2) 実施の形態1では、水素終端ダイヤモンド半導体層
形成工程S1、すなわちダイヤモンド基板21上に終端が水素になっているダイ
ヤモンド半導体層22を形成する工程を経てMIS型半導体装置101を製造す
る方法を説明した。 実施の形態2では、水素終端ダイヤモンド半導体層形成工
程S1に代えて、図6に示すように、ダイヤモンド半導体露出部材準備工程S
11と水素終端処理工程S12とし、他の工程は実施の形態1と同様にしてMI
S型半導体装置を提供する。
【0054】 実施の形態2では、最初に、ダイヤモンド半導体が露出した部材を準
備する(工程S11)。ダイヤモンド半導体が露出した部材としては、ダイヤモ
ンド半導体基板、およびダイヤモンド半導体の第1主表面の一部が露出し、一部
に導電層または/および素子分離用などの絶縁層が形成された部材を挙げること
ができる。その後、露出したダイヤモンド半導体の少なくとも一部を水素終端処
理する(工程S12)。 水素終端処理の方法としては、水素ガス下でのプラズ
マ、または熱処理を挙げることができる。プラズマを用いた場合を例にとると、
MP-CVD装置を用い、H2流量500sccm、圧力4KPa、ヒーター設
定温度600℃およびマイクロ波出力300Wの条件で10分処理する方法を挙
げることができる。 以下、真空or不活性ガス環境処置(S13)は実施の形
態1の真空or不活性ガス環境処置(S2)、窒化ホウ素絶縁体層形成工程(
S14)は実施の形態1の窒化ホウ素絶縁体層形成工程(S3)、および導電体
層形成工程(S15)は実施の形態1の導電体層形成工程(S4)と同様とすれ
ばよい。 以上により、実施の形態1と同様の特性を有するMIS型半導体装置
を提供することができる。
【実施例】
【0055】 以下では実施例により本発明をさらに詳細に説明するが、この実施例
はあくまで本発明の理解を助けるためここに挙げたものであり、本発明をこれに
限定するものではない。
【0056】 (実施例1)
<素子構造>
実施例1のMIS型半導体装置201の素子構造を要部断面構造図である図7を
参照しながら説明する。ここで、図7(a)は、上面から見た平面視図で、図7
(b)および図7(c)は、それぞれ図7(a)のAとA′およびBとB′を結
んだ線で断面をとったときの断面図を示す。また、図7では構成をわかりやすく
説明するために、その構成要素を矩形などで単純化して示している。このMIS
型半導体装置201は、ダイヤモンド基板31、水素終端層32、ゲート絶縁膜
33、ゲート電極34G、ソース電極37Sおよびドレイン電極37D、ゲート電
極配線62G、ソース電極配線62S、ドレイン電極配線62Dおよび絶縁膜61
からなる。 ここで、ソース電極37Sおよびドレイン電極37Dは、上から厚さ
5nmの白金(Pt)からなる導電膜36、厚さ5nmのTiからなる導電膜3
5、およびダイヤモンド基板31と導電膜35のTiとの界面に生成される炭化
チタン(TiC)からなる低抵抗化層42で構成される。 ゲート絶縁膜33は、
六方晶窒化ホウ素(h-BN)で、その膜厚は23nmである。
【0057】 ダイヤモンド基板31には、ゲート絶縁膜33の直下に位置するチャ
ネル部に水素終端層32、導電膜35の直下に位置するTiCからなる低抵抗化
層42、および残りの表層部に酸素終端層43の各領域が形成されている。
【0068】 ゲート電極34Gは、厚さ20nmのグラファイトからなる。そして、
そのゲート電極34Gに厚さ10nmのTiおよび厚さ100nmのAuが順次
積層されたゲート電極配線(ボンディングパッド配線)62Gが形成されている。
【0056】 ソースは、厚さ5nmのTiおよび厚さ5nmの白金(Pt)からな
るオーミック接触用の導電膜(それぞれ図7中の35、36)とソース電極配線
(ボンディングパッド配線)62Sからなる。ここで、ソース電極配線62Sは厚
さ5nmのTi、厚さ5nmのPt、厚さ10nmのTiおよび厚さ100nm
のAuが順次積層された構造となっている。また、導電膜35とダイヤモンド基
板31の境界領域には、TiCからなる低抵抗化層42が形成されている。 同
様にドレインは、厚さ5nmのTiおよび厚さ5nmのPtからなるオーミック
接触用の導電膜(それぞれ図7中の35、36)とドレイン電極配線(ボンディ
ングパッド配線)62Dからなる。ここで、ドレイン電極配線62Dは厚さ5nm
のTi、厚さ5nmのPt、厚さ10nmのTiおよび厚さ100nmのAuが
順次積層された構造となっており、導電膜35とダイヤモンド基板31の境界領
域には、TiCからなる低抵抗化層42が形成されている。
【0060】 また、チャネル層32がゲート電極配線(ボンディングパッド配線)
62Gと十分絶縁されるように、ゲート電極配線62Gが形成されるゲート絶縁膜
33の縁の部分(酸素終端と水素終端の領域の境界)71を覆うように素子分離
用の絶縁膜61が形成されている。絶縁膜61も六方晶窒化ホウ素(h-BN)
で、その膜厚は63nmである。
【0061】 <作製方法>
以下、素子作製工程を断面図である図8から図13を参照しながら説明する。こ
こで、図8-10は図7(a)のAとA′を結んだ線での断面図、および図11
-13は図7(a)のBとB′を結んだ線での断面図である。 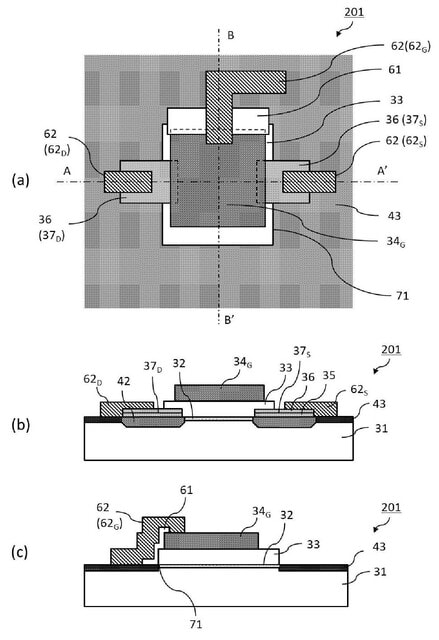
図7.実施例1のMIS型半導体装置の構造を示す断面図。
(a)は上面から見た平面視図、(b)は(a)のAとA′を結ぶ線で断面をと
ったときの断面図、(c)は(a)のBとB′を結ぶ線で断面をとったときの断
面図
【0062】 1.基板の準備
ダイヤモンド基板31としてロシアTISNCM研究所製の高温高圧合成IIa
(111)ダイヤモンド単結晶基板を準備し、通常の方法で熱混酸および有機洗
浄により基板の清浄化を行った。ここで、用いたダイヤモンド基板31の大きさ
は2.5mm×2.5mm×0.3mmである。
【0063】 2.アライメントマークの作製
レーザーリソグラフィにより、アライメントマークをダイヤモンド基板31上に
形成した(図示なし)。 ここで、アライメントマークの形成工程を以下に示す。
最初に、ダイヤモンド基板31の表面に下層レジストPMGI-SF6S(Mi
crochem製)をスピンコートし、180℃で5分ベークした。その後、フ
ォトレジストAZ-5214E(メルクパフォーマンスマテリアルズ製)をスピ
ンコートし、110℃で2分ベークした。 次に、高速マスクレス露光装置(ナ
ノシステムソリューションズ製、DL-1000/NC2P)を用いて、アライ
メントマークパターンを描画した。TMAH(水酸化テトラメチルアンモニウム
)2.38%で合計150秒現像した後、純水で合計120秒洗浄し、その後
窒素ブローを行った。
この項つづく
Anytime Anywhere ¥1/kWh era
【再エネ革命渦論 197 アフターコロナ時代 186】
技術的特異点でエンドレス・サーフィング  ウイルス解体新書
ウイルス解体新書
変異株「JN.1」とは 新型コロナ第10波到来か?
2023年12月の時点で、それほど多くなかった新型コロナウイルスの感染者が、1月
に入り急激に増えてきた。11月下旬ごろから感染者が増え始めてきましたが、1医
療機関あたりの患者数は12月の最終週で5.79人でした。ところが、1月になると
感染が広がるスピードが上がり、直近の1月15~21日は、12.23人になっている。
理由は二つ。一つは、気温がぐっと下がってきたということです。呼吸器の感染
症は、気温が下がると感染が広がる傾向があります。室内に籠もりがちになり、
換気もしないということが要因の一つとして考えられる。もう一つは、ウイルス
がヒトに感染しやすく変異していることが挙げられる。12月に日本で多かったの
は、XBB系統の「EG.5」というタイプでしたが、1月に入ると、BA2.86系統の「
JN.1」が多くなる。1月25日に東京都が公表したデータによると、調査した検体
の55.6%がJN1だ。
JN1はどのような特徴か?
EG.5とJN.1は、感染したりワクチンを接種したりして獲得した免疫から逃れる
傾向にあると言われています。加えてJN.1は、EG.5よりも感染力がやや強いの
ではないかと考えられている。今のところ、重症者が増えたという報告はない。
高熱が出るインフルエンザの方が、症状が重くなる印象。
インフルエンザの感染も心配もあるが?
1医療機関あたりの患者が33.72人だった23年12月の初旬以降、感染者は減ってい
たが、年が明けると増加に転じ、1月15~21日の週は17.72人でした。「A香港型
」として知られるA(H3N2)型に加えて、09年に新型インフルエンザとして流行し
たA(H1N1)型、B型の感染者も目立つようになったことが影響していると考えら
る 学校の冬休みが終わり、授業が始まる。そうした状況もあり、今後も感染者
は増え続けると予想される。 via 読売新聞 ヨミウリドクタ- 2024.1.30


釜山港へ帰れ/돌아와요 부산항에
チョー・ヨンピル 1972.02
● 今夜の寸評 :フリンジンに立つも、夢をあきらめない。






























※コメント投稿者のブログIDはブログ作成者のみに通知されます